摘要:本文详细介绍了具有国际前瞻性和前沿基础性的一种新型IGBT器件——逆导型IGBT。该结构将传统与IGBT芯片反并联封装在一起的FRD(快恢复二极管)集成在同一芯片上,大大提高了功率密度,降低了芯片面积、制造成本和封装制程,同时提高了产品可靠性,将成为未来主流发展趋势。本文从器件结构,物理模型,优缺点,背面版图设计等方面进行深入研究剖析,阐述了逆导型IGBT器件理论及技术基础。最后根据逆导型IGBT的发展现状对其未来发展趋势做出了预测。
1 引言
IGBT(Insulated Gate Bipolar Transistor,绝缘栅双极型晶体管)自1982 发明以来,已经成为当前功率半导体中最重要的器件之一。它以其良好的综合性能广泛应用于诸多领域,如家用电器、交通运输、电机控制、牵引传动、智能电网等。目前,IGBT无可替代地垄断着大约10—100kH***************************************************************************************************************************************************************************************************************************************************的中高压中大电流的应用范围。经过近30年的发展, IGBT在理论上和技术上不断推陈出新,已经从最早的PT结构经历了NPT、Trench、FS等数代技术革命,各种新结构和衍生器件层出不穷[1]。
逆导型IGBT是当前国际上一种新型的IGBT器件[2],最早提出于1988年[16],它是将传统的IGBT元胞结构与FRD元胞结构巧妙集成于同一芯片[3],提供了一个紧凑的电流泄放电路。相对传统IGBT器件,逆导型IGBT在成本和性能上具有很大优势,加上巨大的市场需求使得逆导型IGBT成为国外各大厂商研究的焦点。逆导技术掀起了IGBT的又一次技术革命。
2010年初,Infineon和Fairchild先后推出了各自的逆导型IGBT产品[17] [18],主要的市场定位为低压的电器应用。ABB宣称将于2012年推出3300V的BIGT[7][12]HiPak模块 [19]。另外,Mitsubisbi、TOSHIBA、富士电机等诸多公司对逆导型IGBT也进行了大量的研究。但截止到目前,我国对逆导型IGBT的研究甚少,几乎为空白。从当前的发展局势来看,尽早开始对RC技术的研究已经势在必行了。
2 逆导型IGBT 原理
2.1基本概念
目前,国外各大厂商对逆导型IGBT的命名稍有差别。Infineon称其为Reverse Conducting IGBT[4],缩写为RC-IGBT。Fairchild则命名为Shorted Anode IGBT,简称SA-IGBT。ABB公司称其逆导IGBT产品为Bi-mode Insulated Gate Transistor,简称BIGT[5][6][7],此处的两种模式分别是指正向导通时的IGBT模式和反向导通时的Diode模式。别外,还有文献称逆导型IGBT为SC-IGBT(Segment Collector IGBT或Shorted Collector IGBT)、集电极短路IGBT、阳极短路IGBT等。以上这些称呼虽然有些差别,但是基本的原理都是基于阳极短路技术,而阳极短路技术在GTO,JBS,MPS中也有应用。
2.2结构原理及优点
逆导型IGBT的原理性结构如图1所示。其中图A为传统IGBT的结构,图B为逆导型IGBT的原理性结构。对比可以发现逆导型IGBT的大部分结构与传统的IGBT结构相似。最大的区别是,逆导型IGBT的集电极不是连续的P+区,而是间断地引入一些N+短路区。

图1 传统IGBT与逆导型IGBT结构对比[6][8]
从图1B可以看到,逆导型IGBT的P-基区、N-漂移区、N+ buffer层及N+短路区构成了一个PIN二极管。逆导型IGBT等效于一个IGBT与一个PIN二极管反并联,只不过在同一芯片上实现了。当IGBT在承受反压时,这个PIN二极管导通,这也正是称其为逆导型IGBT的原因。在关断期间,逆导型IGBT为漂移区过剩载流子提供了一条有效的抽走通道,大大缩短了逆导型IGBT的关断时间。
逆导型IGBT的思想节省了芯片面积、封装、测试费用,降低了器件成本[9]。此外,它还具有低的损耗、良好的SOA特性、正的温度系数,以及良好的软关断特性[6][13][14]、短路特性以及良好的功率循环特性[5][15]。
2.3逆导IGBT的snap-back现象
然而,逆导型IGBT在拥有诸多优点的同时,也带来了些问题。最主要的是Snap-back现象[7]和hysteresis现象[10][11]。(关于Snap-back与hysteresis目前没有统一的中文翻译,本文采用“回跳”和“回滞”两个概念。)
典型的逆导型IGBT的I-V特性如图2(A)中的红线所示。在逆导型IGBT导通初期,电流密度很小,VCE很大。但当VCE大于一个特定值VP时,VCE会陡降,电流密度则陡增。电流电压的变化有点类似双极性晶体管的二次击穿,当然其原理与二次击穿完全不同。I-V特性曲线上出现了一大段负阻区,这种现象即为snap-back现象(也称为switch-back现象,很多文献对于I-V特性曲线上出现负阻区的现象都称为snap-back现象,但不同情形下的snap-back现象其原理是截然不同的)。如果电流密度继续增加,I-V曲线上还会出现一系列的小幅snap-back现象,如图2(A)中的I-V曲线出现了一系列锯齿。为了便于区分,有文献[7]将第一次较大的snap-back称为Primary snap-back现象。相对而言,随后的一系列小幅snap-back也称为Secondary snap-back现象。

有文献[11]提到,在测量横向逆导型IGBT的I-V特性曲线时,电流密度逐渐增加时的I-V特性曲线与电流密度逐渐减小时的I-V特性曲线不完全重合,如图2(B)所示。这种现象类似磁滞回线,故称其为hysteresis现象(回滞)。
产生snap-back现象的原理不难解释。如图3所示,在逆导型IGBT导通初期,器件是单极导通的,可以说是工作在VDMOS模式。电子从沟道注入N-漂移区,几乎垂直流向集电极,当流入buffer层后,电子流汇集到集电极短路区后流出器件。从图中可以看到,在P+区上方,电子是横向流到N+短路区的。这样从P+区边缘到P+区中央电势逐渐下降,而这个电势与P+区的电势决定了集电结是否开启。起初电子电流密度小,如图3(A)所示,所产生的压降不足以使集电结开启。集电结两侧电势处处小于其内建电势(Vmg

至于Secondary snap-back现象出现的原因是由于实际芯片内部元胞的不一致性。导通过程中少数元胞首先进入电导调制状态,然后向周边扩散,元胞逐次发生电导调制,也就会观察到一系列Secondary snap-back现象。
总之,Primary snap-back现象是逆导型IGBT少数元胞最先从VDMOS模式向IGBT模式转变所致。而Secondary snap-back现象出现是芯片内部元胞依次从VDMOS模式向IGBT模式转变所致。
逆导型IGBT的hysteresis现象是由于逆导型IGBT元胞一旦从VDMOS模式进入IGBT模式后,便进入一个相对稳定的状态。也就是说想使一个元胞从IGBT模式返回到VDMOS状态,需要的电流密要比使其从VDMOS状态进入到IGBT模式的电流密度要小一些。类似于施密特触发器。实验研究表明,逆导型IGBT开通时各元胞逐次导通,而在关断时所有的元胞倾向于同时关断。而且从图2(B)中可见,逆导型IGBT关断时也有轻微的snap-back现象出现。
3逆导型IGBT背面版图设计[12]
逆导型IGBT的正面结构与传统IGBT基本相同,不同之处在于其背面结构。在制造过程中逆导型IGBT要比传统IGBT多用一块到两块掩膜板,而且背面的版图设计与正面差别较大。一方面背面版图的图形尺寸很大,另一方面图形是非对称、非重复性的,而仿真不可能在对整个器件进行仿真,也就使得对逆导型IGBT一些参数的仿真是近似性的。然而背面版图设计的优劣直接决定了器件和整体性能,尤其是对于回跳现象的消除和二极管的特性的优化至关重要。这就使逆导型IGBT背面的版图布局成为一项关键技术。随着背面版图思想的发展,逆导型IGBT的snap-back现象逐步改善,甚至消除。
3.1 基本的版图布局思想
为了减小Snap-back的影响,P+集电极和N+短路区的掺杂浓度与尺寸都要经过特殊设计。理论及实验表明:①通过增加LP(P+区宽度)及P+区上方N+ Buffer层的电阻率,可以使发生Primary snap-back现象的峰值电压VP显著减小,从而使逆导型IGBT在更小的电流密度下进入IGBT模式;②LN(N+区宽度)的大小对发生Primary snap-back现象的峰值电压VP关系不大,但增加LN能增加发生snap-back现象时的电流密度;③减小buffer层的掺杂浓度,可以大幅减小VP,但是buffer的改变将会强烈影响器件的其它特性,如击穿电压、漏电流及短路耐量。
通过增加LP、减小buffer层的掺杂浓度可以有效减小snap-back现象的影响,但是难以从根本上消除snap-back现象。后来人们提出了多种改进的布局思想,彻底消除了逆导型IGBT的snap-back现象,从而使现在的逆导型IGBT拥有和普通IGBT一样光滑的I-V特性曲线。
3.2 pilot结构及原理
Pilot中文翻译为“引导”比较形象,他的基本是思是在逆导型IGBT背面设置一块大面积的P+集电区。为了便于理解,我们可将器件分为pilot IGBT区与逆导区,如图4中虚线左边为pilot IGBT区,而虚线右边为逆导区。这样在器件导通初期,虽然电压及电流密度很小,但pilot IGBT部分会首先导通,发生电导调制效应。随着电流密度进一步增加,电导调制的区域从pilot IGBT区向逆导型IGBT区域逐渐扩展。从而基本避免了Primary snap-back现象的出现。也就是说,其中的IGBT部分在BIGT导通初期起到了引导的作用。因此,也有很多文献称其为Pilot IGBT。
除了能在导通初期引导IGBT开启外,pilot IGBT区的引入可以使逆导型IGBT区的版图优化只针对增大二极管导通面积独立进行,提高了设计时的自由度。
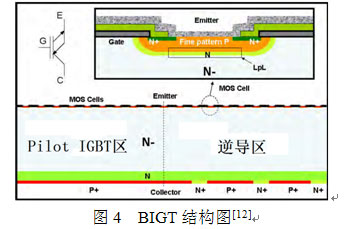
图5所示是由仿真得到的BIGT在不同阶段时空穴电流的分布 [12]。图中从上到下电流密度逐渐增大。可以看出在第1、2阶段,逆导型IGBT还没有空穴从集电极注入,直到第3阶段电流密度大到一定程度,集电结才部分正偏,注入了少量空穴。当达到第4阶段所示的电流密度时,一个集电结充分导通,注入大量空穴,产生了Primary snap-back现象。而对于包含了pilot区的逆导型IGBT,即使在电流密度很小的时候,pilot IGBT部分就已经导通,发生了电导调制,从而不会出现明显的Primary snap-back现象。
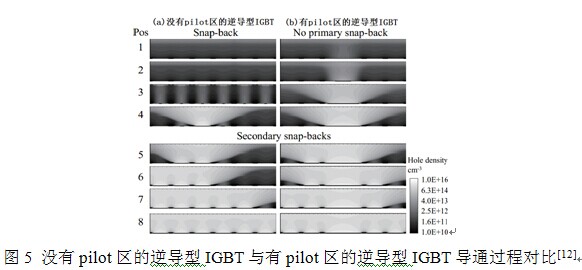
电流密度进一步增加时,没有pilot区的逆导型IGBT与有pilot区的逆导型IGBT空穴注入区都会从已导通的部分向未导通的部分扩展,集电结依次导通,从而两者都能观察到Secondary snap-back现象。
从以上的仿真可知,pilot区的引入能够有效消除Primary snap-back现象,但却不能改善Secondary snap-back现象。
3.3 P+集电区与pilot区正交 [12]
图5中所示的两个不同结构的器件在导通的过程中也是突变式的扩展,这是造成Secondary snap-back的根本原因。如果想消除Secondary snap-back的影响,就要使逆导型IGBT在导通过程中空穴注入区连续扩展。通过研究,将P+集电区设计成与pilot区垂直的版图布局,或采用连通的P+集电区布局都可以达到这种效果。图6(A)给出了两种不同的逆导型IGBT集电极布局方案,短路区均为条形线段。图中白色区域为P+集电区,黑色部分为N+短路区。中间的较宽的白色区域为pilot IGBT区,两侧为逆导区。两者不同之处在于,S1的条形P+集电区区与Pilot IGBT边界平行,而S2的条形P+集电区与Pilot IGBT边界垂直。

仿真结果表明S2的布局更合理,如图6(B)所示的I-V特性曲线。从图中可见S2有的导通压降较低,更重要的没有出现Secondary snap-back现象。而采用S1布局的逆导型IGBT有轻微的Secondary snap-back。两者的反向特性相同,也即Diode模式的特性曲线是重合的,这是因为它们的集电极短路区面积相等。
通过仿真,可以得到不同电流密度下,两种逆导型 IGBT的空穴注入情况,如图7。从图中我们可以看出,在相同的电流密度下,采用S2布局的逆导型 IGBT发生空穴注入的集电极面积最大,也就是说电导调制程度最高,导通压降最低。更重要的是,集电极注入空穴的区域是连续扩散的,这就是避免Secondary snap-back现象出现的关键所在。而S1布局所对应的扩展过程中都是突变式的,发生Secondary snap-back也就再所难免了。
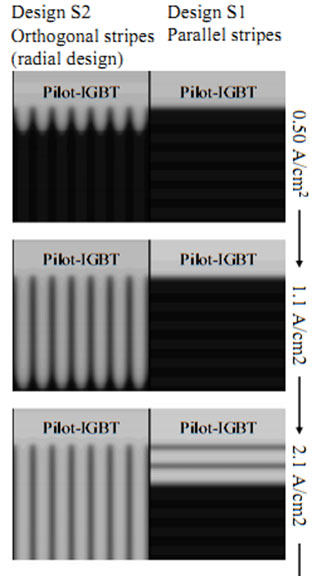

图7 三种条形短路区布局BIGT的导通过程[12]
从以上的仿真可知,在引入pilot区的基础上,使条形的P+集电区与Pilot IGBT边界垂直可以消除Secondary snap-back现象。Infineon的芯片版图设计中是将所有的P+集电极区域连通,这样也能保证器件在导通过程中空穴注入区连续扩展,从而也消除了Secondary snap-back现象。通过以上的版图布局,逆导型IGBT的snap-back现象被彻底消除了。实际上,现在的逆导型IGBT产品拥有和普通IGBT一样光滑的I-V特性曲线。
4结论
最初人们将IGBT及FRD反并联来实现IGBT的逆导应用。为进一步降低成本、提高性能,人们提出了逆导型IGBT结构,将IGBT与Diode做到同一芯片上。这样不仅提高了可靠性,还降低了成本,减小了产品体积。同时逆导型IGBT具有良好的SOA特性、正的温度系数、软关断特性、良好的功率循环特性、良好的温度特性、良好的浪涌电流承受能力等诸多优势。当然逆导型IGBT也有一些缺点,比如snap-back现象。但通过合理的版图布局可以基本上消除snap-back现象的不良影响。
总体上说,传统的IGBT各方面性能已经接近极限。激烈的市场竞争迫切需求更低成本、更高性能的IGBT器件。逆导型IGBT由于其突出的优势成为各大厂商研究的重点,逆导技术也可能成为下一代IGBT的关键性技术。目前Infineon和Fairchild已经推出其逆导产品, Infineon的相关产品已经覆盖了很宽的电压电流等级。ABB也将于2012年量产其高压逆导型IGBT模块。其它的国内厂商也在加紧逆导型IGBT的产业化进程,瓜分中国市场。
最近几年,国内的IGBT技术正趋于成熟,IGBT的国产化在不久的将来能够成为现实。对于逆导型IGBT这种新型的节能减排、经济高效的器件我国也应该加大研发力度,以缩短与国外科技水平的差距,填补我国在逆导技术领域的空白。
参考文献:
[1] 亢宝位.IGBT发展概述.电力电子[C],2006,5:10-15.
[2] Rahimo M, Klaka S. High voltage semiconductor technologies [C]. Power Electronics and Applications, 2009. EPE'09. 13th European Conference, Barcelona, 2009: 1-10.
[3] H. Takahashi, A. Yamamoto, S. Anon, T. Minato. 1200V Reverse Conducting IGBT[C]. Proc. ISPSD’04, p133, 2004.
[4] 吴红奎.IGBT基础与应用实务[M].北京:科学出版社,2010:21-23.
[5] Rahimo M, Schlapbach U, Schnell R, et al. Reali***************************************************************************************************************************************************************************************************************************************************ation of Higher Output Power Capability with the Bi-Mode Insulated Gate Transistor (BIGT) [C].Power Electronics and Applications,2009.EPE'09.13th European Conference, Barcelona,2009:1-10.
[6] Rahimo M, Kopta A, Schlapbach U, et al. The Bi-mode Insulated Gate Transistor (BiGT) A potential technology for higher power applications[C]. Proceedings of the 21rd International Symposium on Power Semiconductor Devices & IC's, Barcelona, 2009: 283-286.
[7] Storasta L,Kopta A,Rahimo M, et al. A comparison of charge dynamics in the Reverse-Conducting RC IGBT and Bi-mode Insulated Gate Transistor BiGT[C]. Proceedings of the 22rd International Symposium on Power Semiconductor Devices & IC's,Hiroshima ,2010:391-394.
[8] Wigger D, Eckel H –G, Comparison of chip-and module-measurements with high power IGBTs and 逆导型IGBTs[C]. Power Electronics and Applications, 2009. EPE'09.13th European Conference, Birmingham, 2011:1-8.
[9] Ruthing H, Hille F, Niedernostheide F -J, et al. 600 V Reverse Conducting (逆导型)IGBT for Drives Applications in Ultra-Thin Wafer Technology[C]. Proceedings of the 19rd International Symposium on Power Semiconductor Devices & IC's,Jeju Island,2007:89-92.
[10] Vinod Kumar Khanna. Insulated Gate Bipolar Transistor IGBT Theory and Design[M]. USA:Wiley-IEEE Press,2003:36-38
[11] Gartner M,Viet***************************************************************************************************************************************************************************************************************************************************ke D,Re***************************************************************************************************************************************************************************************************************************************************nik D, et al. Bistability and hysteresis in the characteristics of segmented-anode lateral IGBTs[J]. IEEE Trans. Electron. Dev,1998,45:1575-1579.
[12] Storasta L,Rahimo M,Bellini M,et al. The radial layout design concept for the Bi-mode insulated gate transistor[C]. Proceedings of the 23rd International Symposium on Power Semiconductor Devices & IC's,San Diego,2011:56-59.
[13] KOPTA A,RAHIMO M,EICHER S,et al. A Landmark in Electrical Performance of IGBT Modules Utilising Next Generation Chip Technologies[C]. Pro -ceedings of the 18rd International Symposium on Power Semiconductor Devices & IC's,Naples,2006:1-4
[14] Satoh K,Morishita K,Yamaguchi Y,et al. A newly structured high voltage diode highlighting oscillation free function in recovery process[C]. Proceedings of the 12rd International Symposium on Power Semiconductor Devices & IC's,Toulouse,2000:249-252
[15] WIGGER W,ECKEL H –G. Comparison of the Power Cycling Stress between IGBT and BIGT Inverters[J], PCIM 2010.
[16] Akiyama H.A collector shorted insulated gate bipolar transistor.PCIM 88 Proceedings,1988, 142-151
[17]Technology Media.英飞凌推出适用于节能家电的创新功率转换器件;600V RC IGBT驱动系列满足变频电机系统的设计要.http://www.infineon.com/cms/cn/corporate/press/ news/releases/2010/ INFIMM201001-022.html. 2010. 1
[18] Fairchild. 1200V, 20A Shorted Anode™ IGBT. http://www.fairchildsemi. com/pf/FG/ FGA20S120M. html. 2010. 4.
[19] 13. ABB. HiPak™ IGBT ModulesABB Semiconductors http://www05.abb.com/ global/ scot/scot256.nsf/veritydisplay/1238a11166a34171c125787e002b8d2c/$file/abb_flyer_hipak_a4.pdf. 2011. 4.
作者简介:
张文亮:男,1987年出生,博士研究生,目前研究方向为高压IGBT器件、逆导型IGBT器件设计。
朱阳军:男,1980年出生,博士,研究员。中国科学院微电子研究所硅器件与集成技术研究室副主任,IGBT项目组和测试及可靠性课题组负责人,中国物联网研究发展中心电力电子器件研发实验室负责人。主要从事IGBT/FRED等电力电子器件芯片开发与产业化以及测试可靠性等研究工作,目前承担国家重大科技专项、中科院重点方向项目等十余项任务。现带领团队正致力于面向智能电网、新能源汽车、轨道交通等高端应用领域的国产自主IGBT技术及产业化攻关。目前,600V-6500V全电压档系列IGBT设计及工艺关键技术已经全面贯通,部分产品已实现批量产业化。