摘要:主要介绍了IGBT (Insulated Gate Bipolar Transistor) 的基本结构和工作原理,分析讨论了IGBT的各个关键参数和结构设计中需要考虑的主要因素。 分析了IGBT设计中需要协调的几对矛盾参数的关系及影响IGBT可靠性的关键因素。
关键词: IGBT;关键参数;结构设计;可靠性
The Key Design Points of IGBT
Jingchao Zhang, Shanqi Zhao, Lifeng Liu, Xiaobao Wang
(MacMic Science & Technology Co., Ltd. Changzhou 213022, China)
Abstract: The basic structure and operation mechanism of IGBT are introduced. The key electrical characteristics are discussed, as well as the key factors which should be considered when designing an IGBT. The trade-offs between different characters of an IGBT and the influences on its reliability are also analyzed.
Keywords: IGBT;key characteristics;structure;reliability
作为新型电力半导体器件的主要代表,IGBT被广泛用于工业、信息、新能源、医学、交通、军事和航空领域[1]。随着半导体材料和加工工艺的不断进步,IGBT的电流密度、耐压和频率不断得到提升[2]。目前,市场上的IGBT器件的耐压高达6500V,单管芯电流高达200A,频率达到300kHz。在高频大功率领域,目前还没有任何一个其它器件可以代替它。本文着重分析讨论IGBT器件的设计要点。
一、IGBT的基本结构和工作原理
从图1可以看出,IGBT是一个复合器件,由一个MOSFET和一个PNP三极管组成,也可以把它看成是一个VDMOS和一个PN二极管组成。图2是IGBT的等效电路.
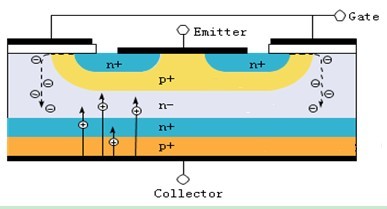 图1 IGBT原胞的基本结构
图1 IGBT原胞的基本结构
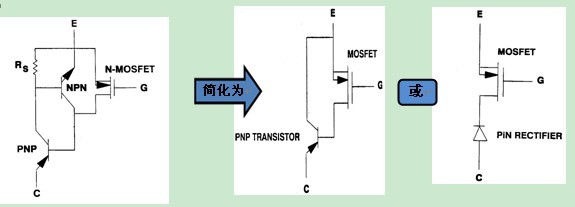
图2 IGBT器件的等效电路图
1. IGBT的 静态特性
常规IGBT只有正向阻断能力,由PNP晶体管的集电结承担,而其反向的电压承受能力只有几十伏,因为PNP晶体管的发射结处没有任何终端和表面造型。
IGBT 在通态情况下,除了有一个二极管的门槛电压(0.7V左右)以外,其输出特性与VDMOS的完全一样。图3 一并给出了IGBT器件的正、反向直流特性曲线。
IGBT 的主要静态参数:
l 阻断电压V(BR)CES – 器件在正向阻断状态下的耐压;
l 通态压降VCE(sat) – 器件在导通状态下的电压降;
l 阈值电压VGEth – 器件从阻断状态到导通状态所需施加的栅极电压 VG 。
 图3 IGBT器件的正、反向直流特性
图3 IGBT器件的正、反向直流特性
2. IGBT的开关特性
IGBT的开关机理与VDMOS完全一样,由MOS栅来控制其开通和关断。所不同
的是IGBT比VDMOS在漏极多了一个PN结,在导通过程中有少子空穴的参与,这就是所谓的电导调制效应。 这一效应使得IGBT在相同的耐压下的通态压降比VDMOS的低。由于在漂移区内空穴的存在,在IGBT关断时,这些空穴必须从漂移区内消失。与VDMOS的多子器件相比,IGBT双极器件的关断需要更长的时间。
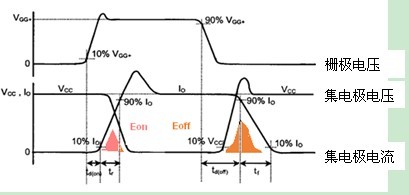 图4 IGBT器件的开关特性
图4 IGBT器件的开关特性
IGBT 的主要开关参数:
l 开通时间 (td(on)+tr) – 器件从阻断状态到开通状态所需要的时间;
l 关断时间 (td(off)+tf) – 器件从开通状态到阻断状态所需要的时间;
l 开通能量(Eon) – 器件在开通时的能量损耗;
l 关断能量(Eoff) – 器件在关断时的能量损耗。
二、IGBT设计中的关键参数
对于一个功率半导体器件而言,关键是器件的长期工作可靠性,而影响可靠性关键的因素就是器件的功率损耗。这一点对大功率高频器件尤为重要。当然,功耗越小,则器件的可靠性就越高。IGBT的功率损耗主要体现在其反向阻断状态、导通状态及开关状态。而影响上述三个状态损耗的主要参数如下。
1. 反向阻断电压
IGBT处于阻断状态时,希望在承受额定阻断电压时,器件的漏电流越小越好。这样,器件在阻断状态下的功率损耗越小。
影响耐压的几个因素:
* 漂移区的电阻率的增加,耐压增加;
* 漂移区的厚度的增加,耐压增加;
* 栅极宽度的增加,耐压减少;
* 终端结构。



图5 影响IGBT器件耐压的主要因素[4]
2. 通态压降
IGBT的通态压降VCE(sat)由下面的电阻构成:

对高压IGBT而言,主要影响VCE(sat) 的电阻是RJ 和RD,即JFET区域的电阻和N- 漂移区内的电阻。 因此,如何尽量降低RJ 和RD是大功率IGBT设计中应重点考虑的。下面将要提到的沟槽栅结构和场阻断结构就是为了减少RJ 和RD。
要获得最低的正向压降,最佳的漂移区的设计为:
厚度: 
浓度:
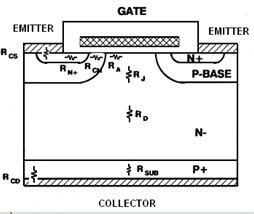 图6 IGBT器件导通电阻的分布
图6 IGBT器件导通电阻的分布
通态压降VCE(sat) 的大小决定着器件耗散功率的大小[5]:
![]()
其中RθJC 为结壳热阻
3. 开关损耗
IGBT的开关损耗主要由其开关能量及开关频率决定,即:

IGBT的Eon和Eoff主要取决于栅电阻RG,栅源间电容CGE和栅漏间电容CGC,及IGBT
中PNP三极管的增益αPNP。降低RG、CGE和CGC可以同时降低Eon和Eoff ,但是,要注意,发射效率γPNP对开通能量和关断能量的影响是相反的,即αPNP 大,开通时间短,但关断时间长。因此,在设计上要给于折中的考虑。在高频应用线路中,往往希望IGBT的关断时间要短,这样,在一般IGBT的设计中往往尽可能地减少αPNP。这也是为什么在PT-IGBT中要采用n型缓冲层和在NPT-IGBT中要尽可能降低P发射区浓度和厚度的原因。另外,降低αPNP,也有利于抑制IGBT的latch-up效应。
4. 电容
在IGBT器件的设计中要注意以下三个电容:

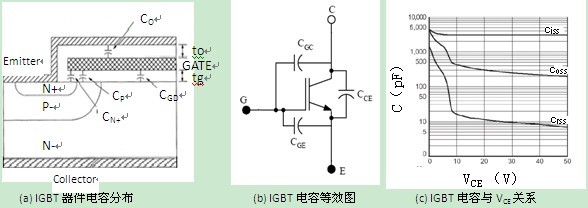
图7 IGBT器件的电容
CGE 栅极–发射极电容, 
CN+ 取决于栅极覆盖N+ 发射区的面积, 栅氧的厚度 tox 越大, N+区的结深越浅,导致CN+ 越小;
栅氧的厚度 tox 越大, N+区的结深越浅,导致CN+ 越小;
CP 取决于栅极覆盖P基区的面积,沟道长度越短, 则 CP 越小 ;
CO 取决于发射极覆盖栅极的面积,
CGC栅极–集电极电容,又称米勒电容, 栅氧的厚度 tox 越大, 栅极覆盖N-的面积越小,则 CGC 就越小。
栅氧的厚度 tox 越大, 栅极覆盖N-的面积越小,则 CGC 就越小。
在设计中,要尽量使米勒电容越小越好。米勒电容越小,器件的开通和关断过程就越短。另外,在半桥线路中,如果米勒电容越大,则越容易引起直通现象。
CCE发射极–集电极电容,取决于N- 漂移区和P井的面积。面积越小,CCE越小。
Ciss 、Coss 和Crss 影响器件的开通和关断时间以及开通和关断延迟时间,进而影响器件的开关损耗。
5. IGBT的频率特性
影响IGBT的频率特性的主要因素:
* 通态损耗和开关损耗越低,则器件的工作频率就越高;
* 散热特性越好,热阻越小,则频率就越高;
* 工作电流越大,则频率越低;
* 器件耐压越高,则频率越低;
* 栅极电阻越小,则频率越高;
* 器件输入电容越小,则频率越高;
* 环境温度越高,则频率越低。
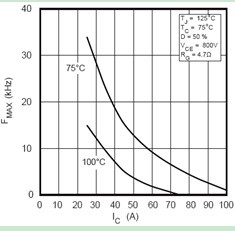 图8 IGBT的工作频率和电流的关系
图8 IGBT的工作频率和电流的关系

三、IGBT的结构设计
1. 有源区结构设计
常用的IGBT的有源区的原胞几何结构主要分为:条形、方形和正六边形。
对通态压降而言,正六边形最小(Ron最小),条形最大(Ron最大);
对抗闭锁能力而言,条形最强 (Rb最小),正六边形最弱(Rb最大)
而且,条形原胞可以获得较好的耐压和通态压降之间的协调关系。
有源区的设计主要要考虑两个值:栅源长度和(LG+LE)和栅源长度比(LG/LE),如图所示。
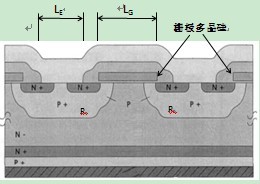 图9 IGBT的原胞结构
图9 IGBT的原胞结构
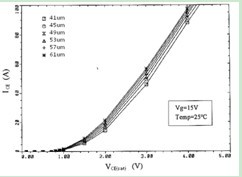 图10 原胞栅宽对通态压降的影响
图10 原胞栅宽对通态压降的影响
* 原胞的栅长度LG与栅源长度和(LG+LE)的比例越小,米勒电容Crss就越小;
* 原胞的栅源长度比(LG/LE)越大,通态压降越小,耐压越低,短路电流越大。
图10可见[4],多晶栅的长度越宽,JFET区域的压降越小,通态压降就越小。
2. 栅极结构设计
栅极主要有两种:平面栅和沟槽栅,如图11所示。
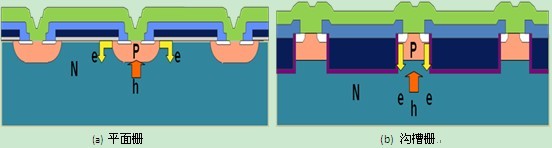
图11 IGBT的栅结构
沟槽栅的优点:
* 通态压降减少,与平面栅相比约小30%左右;
* 电流密度大。
沟槽栅的缺点:
* 沟槽工艺复杂;
* 短路能力低;
* 栅电容大,与平面栅相比约大3倍左右。
1. 终端结构设计
常见的功率半导体器件的终端有一下四种:场限环结构,场板结构,JTE(结终端扩展)结构和VLD(横向变掺杂)结构。对高压IGBT器件,用的最多的,工艺上容易实现的终端结构是场限环结构。有的设计将上述方法结合起来使用。
终端设计中应注意的几个问题:
* PN结的曲率半径要尽可能大;曲率半径越大,承受电压的能力就越强;
* 实际环的宽度,取决于该环承受的电压降及PN结P型区的浓度;
* 实际环的间距,间距太小,则最后一个环承受的电压降较高,反之,第一个环承受的电压降较高;
* 环的表面电荷,影响PN结表面的形状,进而影响该结承受电压降的能力。
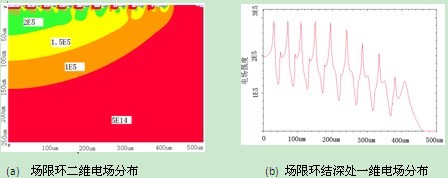 图12 高压IGBT的场限环电场分布[6]
图12 高压IGBT的场限环电场分布[6]
1. 纵向结构设计
漂移区内电场分布主要分为两种:穿通型和非穿通型。PT-IGBT和FS-IGBT属于穿通型,NPT-IGBT属于非穿通型。
穿通型电场分布的结构可以较好的实现耐压与通态压降之间的协调,而非穿通型电场分布的结构,通态压降往往较大,但其短路能力较强。
IGBT主要三种纵向结构(图13):PT穿通型(Punch-Through)、NPT型(Non-Punch-Though)和FS场阻断结构[3]。
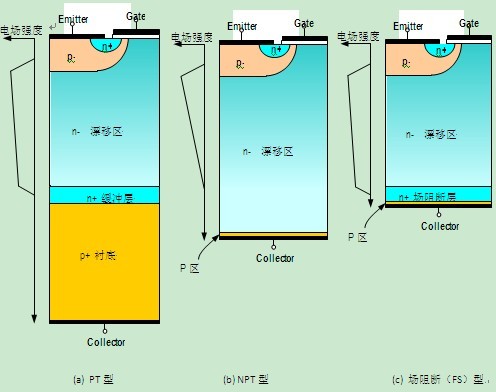 图13 IGBT的纵向结构
图13 IGBT的纵向结构
PT穿通型结构的特点:
* p+ 衬底,n 外延漂移区;
* 电场穿透漂移区,到达n+缓冲层;
* 负温度系数;
* 需要少子寿命控制技术;
* 材料成本高;
l 不需减薄工艺。
NPT非穿通型结构特点:
* 无外延层 ;
* 薄p发射区;
* 电场未穿透漂移区;
* 正温度系数;
* 热阻低;
* 不需要少子寿命控制技术;
* 材料成本低;
* 需要减薄工艺,但减薄后厚度较厚。
FS场阻断结构特点:
* 无外延层;
* 薄p发射区;
* 电场穿透漂移区,到达n+场阻断层;
* 正温度系数;
* 拖尾电流小;
* 通态压降低;
* 不需要少子寿命控制技术;
* 需要减薄工艺,减薄后厚度较薄。
四、影响IGBT可靠性的关键因素
IGBT 是一个MOS控制的双极器件。电场控制型器件的触发电路简单,器件的开关损耗低;双极器件由于少子的电导调制效应,在高电压时,可以获得较低的通态压降。因此,IGBT适用于大电流、高压和高频的应用。然而,也正是因为IGBT的上述特点,设计时需要考虑一下几个问题。
1. Latch-up 效应
如图2中所示,由于IGBT有一个寄生的PNPN晶闸管存在,因此,必须抑制该晶闸管中的NPN晶体管的开通,如果设计不当,在IGBT导通过程中,寄生的晶闸管被激发,IGBT的栅极将失去控制作用,发生Latch-up现象。
影响Latch-up 的主要因素:
* 电流密度:电流密度越大,越容易发生Latch-up现象,如图13所示;
* 器件结构:采用N+缓冲层和UIS高硼注入,如图14(a) 所示[7];
* 温度:温度越高越容易发生Latch-up现象,如图14(b) 所示。
有效抑制这种现象的做法就是设计和工艺上要使得Rb的值越小越好。控制PNP晶体管的增益αPNP和NPN晶体管的增益αNPN的和(αPNP+αNPN) 小于1. 设计上要使得P基区中的N+发射区下面的横向宽度越窄越好,工艺上要保证N+发射区下面的横向部分的电阻越小越好,即增加N+发射区下面的P区的浓度。另一方面,要尽量减少PNP晶体管的发射效率γPNP,进而减少少子空穴的注入量。
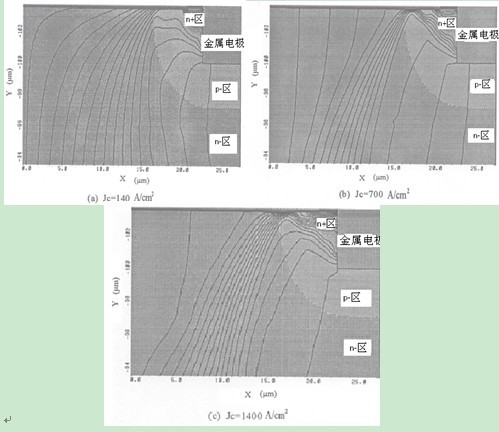
图14 电流密度对Latch-up的影响

图15 Latch-up的主要影响因素
2. 雪崩耐量
雪崩耐量的大小取决于器件雪崩面积的大小和雪崩电流的分布均匀性,雪崩面积越大,雪崩耐量越高。因此,在设计上,,如有源区面积大于终端面积,应保证器件的击穿发生在有源区内(如图16(a)所示)[8],而不是在终端部分(如图16(b)所示)。反之,如有源区面积小于终端面积, 则应保证器件的击穿发生在终端部分。

3. 短路能力
短路能力的大小很大程度上取决于器件的PNP晶体管的增益αPNP。在设计上要保证器件PNP晶体管的基区宽度,即N型漂移区,尽可能宽,或者是PNP晶体管发射极的发射效率γPNP尽可能低,另外,增加原胞的栅源长度比,也有益于提高器件的短路能力。
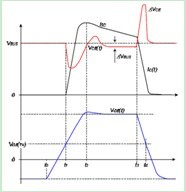 图17 IGBT 短路时的电压和电流
图17 IGBT 短路时的电压和电流
短路失效的主要机理:
1) 芯片散热限制
在短路情况下,器件承受额定(或接近于额定)电压和几倍的额定电流,此时IGBT芯片需要耗散的热量很大,在一定的时间周期内,如果IGBT的结温超出其临界值,器件将发生热逸走现象,最终将芯片烧毁。
2) 过电压
如果Vce远远超出了额定值,器件将被雪崩击穿,此时,所有短路电流将集中到这个狭窄的击穿点上,电流密度巨大,导致器件烧毁。
3) Latch-up 效应
在短路电流流过时,N+发射极下的Rb两端的电压降可能会超过0.6V,引 发了IGBT中寄生的晶闸管的开通,IGBT被Latch-up 了。
4. 温度系数
大电流的应用时,往往需要多个IGBT并联,考虑到并联过程中的均流问题,希望IGBT具有正温度系数。这样,电流增加,导致温升增加,而正向压降随着温度的增加而增加,因此,抑制了电流的进一步增加。起到了均流的效果。要实现正温度系数,设计上就要尽可能地加大电子电流的成分,减少空穴电流的比例。最有效的办法就是减少PNP晶体管的发射效率γPNP。
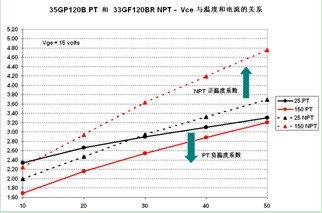 图18 IGBT 的温度系数
图18 IGBT 的温度系数
五、IGBT设计中需要协调的几个参数
1. 通态压降和耐压的关系;
如图19所示,通态压降的大小与耐压的高低成正比,如何进一步降低高压IGBT器件的通态压降一直是IGBT设计的一个重要考量。目前常用的方法:
* 沟槽栅结构;
* 漂移区电场穿通型的设计,即在集电极侧采用N+ 缓冲层结构;
* 发射极端载流子浓度增强。
参考文献
 图19 IGBT 通态压降和耐压的关系
图19 IGBT 通态压降和耐压的关系
1. 通态压降和关断速度的关系;
与VDMOS相比,由于IGBT存在着少数载流子的电导调制效应,因此,可以在同样的耐压下,获得较低的通态压降。然而,由于空穴的存在,延长了器件的关断时间。目前常用的提高关断速度的方法:
* 在集电极侧采用N+ 缓冲层结构;
* 集电极低空穴注入。
图20 给出了不同结构和技术的通态压降和关断时间的关系,曲线越接近于原点,说明技术越先进。

3. 通态压降和短路电流能力的关系。
如图21所示,IGBT的通态压降越小,能够承受短路电流的时间就越短,即器件的短路能力越差。常用的提高短路能力的方法:
* 增加原胞的栅源长度比(LG/LE);
* 在集电极侧采用N+ 缓冲层结构。
五、结论
在高频大功率IGBT的设计中,必须要在减少器件静态和开关功率损耗的基础上,综合考虑其静态、动态及可靠性的各个参数及各个参数之间的协调关系。
参考文献
[1] 王兆安,电力电子设备设计及应用手册[M].北京:机械工业出版社,2002
[2] 陈星弼,超结器件[J]. 电力电子技术,2008,42(12):2-7
[3] M Rahimo, 高压IGBT和二极管SOA性能的突破-SSCM[J]. 电力电子技术,2008,42(11):75-77
[4] Shanqi Zhao etc., “A Simulation System for a Power Insulated Gate Bipolar Transistor (IGBT) with TSUPREM-4 and MEDICI Simulators”, 7th European Simulation Symposium, Erlangen, October, 1995.
[5] John Hess, IGBT Tutorial, J J Application Note APT0201 Rev. B002, July, 2002
[6] 陆界江,张景超等,高压功率器件结终端结构设计,中国电工技术学会电力电子学会第十一届学术年会,中国杭州,11月15~17日,1129
[7] Shanqi Zhao etc., “Simulation on Latch-up Effects of a High Power Insulated Gate Bipolar Transistor (IGBT)”,IPEMC'97, November 3-6, 1997, Hangzhou, China
[8] Shanqi Zhao etc., US 2004/0164347A1, Design and Fabrication of Rugged FRED[P]. 2004