摘要:从di/dt损坏机制、定量公式入手,分析了国内外有关di/dt的著作、文章,研究了提高晶闸管器件di/dt能力的各种有效方法,给出了一个常规新设计及其研究成果。
关键词:晶闸管,di/dt能力,放大门极,短路点,扩展速度,强触发
一、 研究di/dt的意义
初始导通过程中,过大的电流上升率di/dt是正常晶闸管器件损坏的主要原因,经对损坏器件解剖分析,70%以上原因都出于此。提高器件承受di/dt的能力,赶上国际最先进晶闸管制造水平,必将成为晶闸管,特别是大容量晶闸管的设计制成乃至应用的重大研究课题。
搞清晶闸管di/dt损坏的机制是研究提高晶闸管器件di/dt能力的前提条件,国内外公认的晶闸管di/dt损坏机制主要有两种:
1、为热疲劳机制,即:
门极电压Vg加上后,由于导通总是从最靠近门极那一部分阴极开始,因此此点电流密度最高、发热最严重、温升也最高,但导通从此点经横向电阻(应该说是横向电场)扩展到其他较大区域后,通过此点的电流很快降下来,温度也迅速降低,其它导通区则温度升高。下一半波来临时,照此循环一次。如此多次循环造成的温度迅变必然产生一定的热应力,此应力到一定数值时,引起硅材料的晶格损伤,造成该处被烧毁。
我们将这种多次循环的温度迅变而造成器件损坏的机制称为热疲劳损坏。
这种破坏机制和每次循环初始上升的最高温度关系最大,局部瞬间温升越高,对晶格产生的热应力将越大,也最易损坏器件,其损坏点在阴极内圈附近,且往往为一大片烧毁面积。
显然di/dt很高时,损坏往往是热疲劳引起的。
2、热逸走机制
器件因耗损功率而产生温升,引起热量,如果这个热量比耗散出去的热量大,则结余的热量又将造成附加温升,从而使结温更高,结余热量更大,温升更高。如此下去,超标很多的结温致使器件损坏。这种器件损坏机制就是热逸走,即热量不是按正常渠道走,而是积累造成芯片局部温度过高而导致损坏。
在较低的电流上升率(如di/dt<200A/μs)损坏,往往都是这种损坏机制。
二、 di/dt估算公式
我们从最简化的di/dt模型入手,给出晶闸管di/dt估算公式及相关说明。
1、双矩形门极、阴极结构,双线性电压、电流波形下的简化电流上升率di/dt估算公式[1]
为使问题讨论简化起见,认为门极、阴极长度相等、且门极窄、阴极宽的双矩形简化结构,其开通时的电压波形、电流波形均为直线,如图1所示:



2、中心门极、双线性电压电流波形近似的di/dt公式[1][2]
对大功率晶闸管器件,常常为中心门极,经积分得公式(3):

扩展速度的研究,以70年鲁尔(Ruhl)横向场理论为准。文献[3]给出vs=(0.05~0.1)毫米/微秒,而文献[2]指出,在有放大门极时,普通同心圆门极下的扩展速度为vs=(0.05~0.1)毫米/微秒,复杂门极对应的扩展速度则为vs=(0.1~1.0)毫米/微秒。考虑到放大门极若不起作用时,对应扩展速度为vs=0.01毫米/微秒。说明门极图形不同,扩展速度相差竟高达100倍!
②晶闸管开通时间ton,即门极触发开通时间tgt。对普通晶闸管tgt=8μs左右,对快速晶闸管tgt=4μs左右,对高频晶闸管tgt=2μs以下。最长对最短在4~5倍。
③△T为导致晶闸管器件因di/dt损坏的温差。设晶闸管额定结温为125℃,热疲劳损坏温度为(360~400)℃,则不重复di/dt损坏的温差为275℃,重复di/dt损坏的温差则为235℃[2] [3]。
3、 对公式(3)的修正[4]
文献[4]对双线性电压电流波形下的公式(3),按实际波形进行了修正。考虑到相对电流波形,电压波形会下降的更快,且不可能降到零的事实,采用两个指数叠加的电压波形来模拟,在计算机的帮助下,重新积分计算,无疑使结果更接近实际测试值。
但随着应用频率的提高,这种由于波形的影响将会越来越小,即越来越接近双直线近似。
更重要的是:真正影响di/dt耐量计算准确性的是电流扩展速度、强触发力度、初始导通面积的大小,而不是电压电流波形。
对于估算di/di耐量大小的公式,采用公式(3),甚至采用公式(2)都是可行的,而把提高di/dt耐量的注意力集中在最主要的影响因素上,这才是最优化的解决问题的关键。
国际标准给出的开通波形表明[5]:双线性近似还是方便的、可行的。
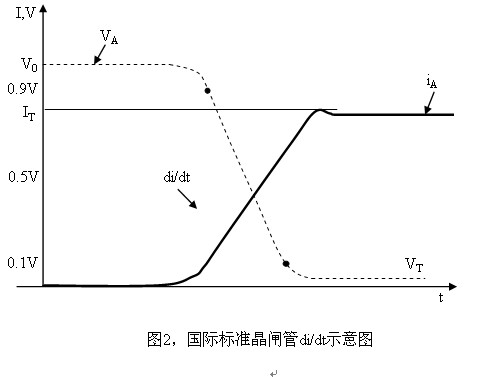
一、 影响di/dt的主要因素
国际著名功率半导体器件专家[美国]格安迪(Ghandhi)[6]、[德国]格尔拉赫(Gerlach) [3]、[英国]泰勒(Taylor) [7]对影响di/dt的主要因素进行了非常详细的说明[3] [6] [7]。这些文献给出了改善晶闸管器件di/dt耐量的方向和主要办法:
1、把最靠近门极的阴极发射区长度设计得长一些,以增大初始开通区的尺寸;
2、通过采用最佳晶闸管设计使扩展速度增到最大(或者叫使扩展时间减到最少),这是改善晶闸管器件di/dt耐量最有效的办法,文献[3]给出了扩展速度的定义:vs=d/tgt,说明只有缩短开通时间,才是提高扩展速度的最好办法。
作为提高di/dt耐量的实例,文献[6]给出由36个指条状的渐开线门极结构,使晶闸管的di/dt耐量改进了25倍以上,di/dt耐量超过了1000安培/微秒。
作为提高di/dt耐量的另一实例,文献[7]给出了不同大小,且呈放射性的短路点分布的光刻版图形,这又是一种提高di/dt耐量的好办法。
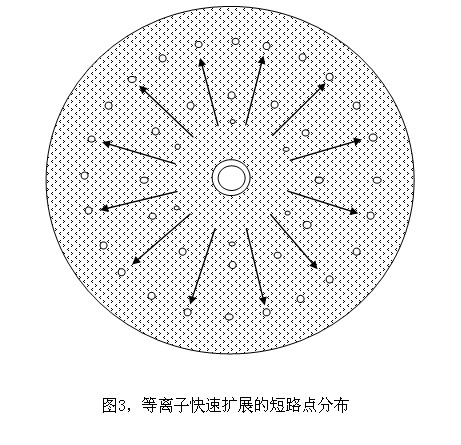
一、 改进di/dt的主要办法
国内外文献[8]~ [15]在文献[1]~ [7]的基础上,从不同角度又进一步给出了相关改进di/dt的有效措施。
国际著名功率半导体专家松泽刚雄的红外研究发现[8],正对短路点的电流将被减速,而在短路点相间处被加速。并进一步给出扩展速度、dv/dt耐量和短路系数的关系即:lnvs∝R,dv/dt∝1/R,说明提高di/dt的设计必须和dv/dt相协调;
文献[9]站在高频晶闸管的高度,详细阐明了短路点对di/dt的影响,明确提出在保证dv/dt的前提下,将短路点,尤其是门极附近的短路点设计得小一点、稀一点,有利于提高di/dt耐量。
文献[10]从近门极的光刻版图形上给出了新颖的梅花瓣式的分布图形,这是提高器件的di/dt耐量的一种崭新设计;
文献[11]从开通模型的角度,正确给出了电流放大系数、触发强度对门极触发开通时间tgt,进而对di/dt的定量关系;
文献[12] 站在测试的角度,详细给出了阳极电压、阳极电流、特别是工作频率等对di/dt的定量关系。
当重复频率不同时,其频率影响可以用下面公式表示;

文献[13] [7] 从硅材料的晶向角度,给出了采用(100)晶向硅单晶以提高器件的提高di/dt能力的国际上流行的先进方法;
文献[14]则是从欧姆接触工艺角度给出了确保di/dt耐量的蒸发层的最薄厚度,即蒸铝层厚度必须≥5μm,一般应≥10μm。
文献[15]揭示了国际著名半导体专家高佑长于1980~1981到中国讲学提到的著名论断:放大门极电阻Rg0对主阴极头排短路点内电阻Rg1的倍数,“一般至少要大4倍、最好10倍、20倍甚至100倍”[15],才能保证放大门极充分起作用。又说:“我本人仍主张在可能的情况下,还是取消放大门极……”
应该说短路发射极对提高大面积器件的dv/dt能力以及高温特性大有好处,但对电流扩展就是很不利的。站在提高di/dt能力的角度,最好不采用短路发射极。高佑长先生又进一步提出,为提高di/dt能力,最好不采用放大门极的方法,原因在于它对di/dt的提高是很有限的,搞不好,还有负作用。GTO或GCT、IGCT就是取消短路发射极和放大门极的最好应用。
文献[16]引用WESTCODE公司的功率半导体器件各种晶闸管产品规格书,给出了不同情况下产品对不重复di/dt值的明确要求:
①2500VC160普通(相控)晶闸管,di/dt为300A/μs;
②K2623T*520中等高压晶闸管,di/dt为600A/μs;
③R2475ZC280快速(分布门极)晶闸管,di/dt为1500A/μs;
④A1237NC280非对称晶闸管,di/dt为2000A/μs;
⑤Y5002NC250脉冲晶闸管,di/dt为11000A/μs。
若再提高单只器件的di/dt耐量,只有寻找更新的电流扩展原理,如俄罗斯著名专家格列霍夫(Grekhov)的反向注入控制的可控等离子体换流原理等,完全摆脱前述器件的横向场理论下的电流扩展速度慢的羁绊。文献[17]向我们展示了俄美等国家的新型脉冲器件,如反向开关晶体管RSD(也叫快速离子化晶体管Fast Ionization Dynistor,简称FID;又叫负阻二极管)的di/dt已高达60KA/μs;而另一种脉冲器件—半导体短路开关SOS(Semiconductor Opening Switch),则是反其道应用硬恢复原理而做成超硬恢复的二极管,使其反向恢复di/dt能力高达1012A/s,即100KA/μs。
一、 研究措施
吸收并总结国内外关于提高di/dt的理论、经验和方法、对常规的晶闸管,我们的改进提高di/dt的措施如下:
强触发以提高扩展速度的措施;改进光刻版图形设计以增加初始导通线长度的措施。其次有单晶材料的晶向、截面电阻率均匀度、残余少子寿命的提高控制措施;协调di/dt和dv/dt的设计问题等等。
对中小功率晶闸管器件(如100A及以下),不采用放大门极转而采用场引入即FI结构,可确保100A/μs以上的di/dt的能力;
对大功率晶闸管器件,要求di/dt=(100~1000)A/μs,比较好的办法仍为采用充分起作用的放大门极的方法;
对di/dt=≥1000A/μs,采用GTO(或GCT)的方法,取消放大门极,取消短路发射极结构,采用合适的阴极条宽,可将di/dt提高到如10000A/μs的水平。
di/dt远大于10000A/μs 的晶闸管就是脉冲晶闸管。
以下是一个具体客户要求的di/dt≧1000A/μs的大功率晶闸管的设计实例,并非是最佳。现对其进行说明:
① 设计光刻版图形。
放大门极电阻对主阴极电阻比例为10倍以上,取Rg0:Rg1=12;
放大门极设两排短路点,即使其拉宽,又不使其对应的电阻过大,以致于影响dv/dt耐量;
插入式再生门极取三根棍式,一根的初始导通线长度还不够(尚不能确保di/dt>500A/μs的能力),四根以上将影响阴极面积,我们的经验是以2~3根为妥,这里的设计为三根;
所有头排短路点直径为d=0.06,其它阴极上的短路点为d=0.09,间距为D≥0.6(不取常规的D/d=4的分布,而取D/d≥6的小而稀的短路点分布);
短路点之间不取正三角形,而是放射状的近似正方形的分布。
②高度协调di/dt和dv/dt的设计
相应提高次表层的浓度,在确保dv/dt满足要求的前提下,尽力采用短路点小而稀分布的高di/dt设计;
触发电流设计得稍大些,如Ig≥100mA,即Rgo≤6Ω-cm,确保安培级的触发电流下,也能保证放大门极充分起作用。
③如果采用非烧结铝的全压接工艺,就可以采用截面电阻率高度均匀的(100)晶向的中照N型硅单晶材料;
④精确控制少子寿命和电子扩散长度,对普通晶闸管器件,工艺保证尽可能高的基区少子寿命τp,依据电压和电流放大系数α1的要求,经过辐照精确控制τp值,从而确保τn值,即确保开通时的足够大的α2的要求,从而确保开通时的深饱和状态(α1+α2≥1.05~1.2)。
对较低di/dt的设计,可以不取插入式再生棍状分布,可仅取同心圆,当然对放大门极外圆和主阴极内圆采用梅花瓣式分布,比仅有同心圆的高近200A/μs的di/dt耐量。
新的光刻版关键部位示意图如下:

一、 研究小结
生产的1000A/4500V普通型晶闸管全部通过di/dt=1000A/μs的测试,极限损坏有1500A/μs下的部分测试记录。
提高并稳定大功率晶闸管器件的di/dt耐量,是确保我国晶闸管器件和国际最先进水平接轨的需要。
对应不同的应用场合,必须严格确保di/dt的要求,对达不到要求的产品,应严格限制其出厂或上机。
参考文献:
[1]西安整流器研究所快速可控硅元件研究组:快速可控硅整流元件动态特性的设计考虑(J)《变流技术动态》 1974.3~4
[2]张继贵 李可儿:大功率晶闸管阴极面图形研究[J] 株洲电力机车研究所 1979年
[3][德国]W.格尔拉赫:晶闸管[M] 卞抗译 机械工业出版社(1984)
[4]古玉书:高压大电流晶闸管电流上升率不重复值的计算[J] 电力电子技术 1991.4
[5]国际标准:IEC60747-6:2000.12第六部分:晶闸管 17
[6][美国]S.K.Ghandhi:功率半导体器件---工作原理和制造工艺[M] 张光华 钟士谦译 机械工业出版社 (1982)
[7][英国]P.D.TAYLOR:晶闸管的设计与制造[M] 庞银锁译 顾廉楚审校 中国铁道出版社 1992年 76~77
[8][日本]松泽刚雄:電力用高速サイリスタにおけるエシツタ短絡效果(J) 日本电气学会论文志 53-C4 1978.1.
[9]王晓彬 王培清 张斌:阴极图形对高频晶闸管di/dt的影响(J)《电力电子技术》 1996第4期 97~99
[10]蓝小平:快速晶闸管动态参数的优化设计(J) 《电力电子技术》 1987
[11]潘福泉,王玉良,李量钧:沟通模型和晶闸管门极控制开通时间(J) 《变频技术应用》 2012.3
[12]孟繁栋:晶闸管动态参数测试(J)《电力电子技术》 1981.1
[13]关艳霞,潘福泉:(100)晶向硅片和功率半导体器件(J)《变频技术应用》 2011第3期
[14]西安整流器研究所元件研究组:可控硅元件阴极面铝蒸发层消失问题的研究(J)《变流技术动态》1976.2
[15][美国]高佑长:电力半导体器件的发展概况及理论设计(J) 《电力电子技术》 1981.4
[16]:WESTCODE产品规格书
普通晶闸管(Phase Control Thyristor) N2500VC160 2001.11.20
中压晶闸管(Medium Voltage Thyristor)K2623T520 2004.2.25
快速晶闸管(Disributed Gate Thyristor) R2475ZC28 2003.5.9
非对称晶闸管(Asymmetric Thyristor) A1237NC280 2005.7.26
脉冲晶闸管(Pulse Thyristor) Y5002NC250 2002.10.15
[17]:余岳辉 梁琳:脉冲功率器件及其应用[M] 机械工业出版社 (2010.6) P10,P204
高占成:北京东菱宏博电气科技发展有限公司高级工程师,总经理。
电话:13801285263,E-mail:gaozhancheng@vip.sina.com