摘要:IGBT(绝缘栅双极晶体管)正是顺应这种要求而开发的,它是一种既有功率MOSFET的高速交换功能又有双极型晶体管的高压、大电流处理能力的新型元件,将有更大的发展潜力。
随着双极型功率晶体管模块和功率MOSFET的出现,电动机可变速驱动装置和电子计算机的备用电源装置等电力变换器,已经起了很大的变化。各种电力变换器也随着近年来节能、设备小型化轻量化等要求的提高而急速地发展起来。但是,双极型功率晶体管模块和功率MOSFET并没有完全满足电力变换器的需求。双极型功率晶体管模块虽然可以得到高耐压、大容量的参数,但是却有交换速度不够快的缺陷。而功率MOSFET虽然交换速度足够快了,但是存在着不能得到高耐压、大容量等缺陷。
IGBT(绝缘栅双极晶体管)正是顺应这种要求而开发的,它是一种既有功率MOSFET的高速交换功能又有双极型晶体管的高压、大电流处理能力的新型元件,将有更大的发展潜力。
1 元件的构造
IGBT的构造和功率MOSFET对比如图1所示。IGBT是通过在功率MOSFET的漏极上追加 p+层而构成的,从而具有以下种种特征。
(1)电压控制型元件
IGBT的理想等效电路,如图2所示,是对pnp双极型晶体管和功率MOSFET进行达林顿连接后形成的单片型Bi-MOS晶体管。因此,在门极-发射极之间外加正电压使功率MOSFET导通时,pnp晶体管的基极—集电极间就连接上了低电阻,从而使pnp晶体管处于导通状态。此后,使门极—发射极之间的电压为0V时,首先功率MOSFET处于断路状态,pnp晶体管的基极电流被切断,从而处于断路状态。

如上所述,IGBT和功率MOSFET一样,通过电压信号可以控制开通和关断动作。
(2)耐高压、大容量
IGBT和功率MOSFET同样,虽然在门极上外加正电压即可导通,但是由于通过在漏极上追加p+层,在导通状态下从p+层向n基极注入空穴,从而引发传导性能的转变,因此它与功率MOSFET相比,可以得到极低的通态电阻。
下面对通过IGBT可以得到低通态电压的原理进行简单说明。
如图1所示,功率MOSFET是通过在门极上外加正电压,使p基极层形成沟道,从而进入导通状态的。此时,由于n发射极(源极)层和n基极层以沟道为媒介而导通,MOSFET的漏极—源极之间形成了单一的半导体(如图1中的n型)。它的电特性也就成了单纯的电阻。该电阻越低,通态电压也就变得越低。但是,在MOSFET进行耐高压化的同时,n基极层需要加厚(n基极层的作用是在阻断状态下,维持漏极—源极之间所外加的电压。因此,需要维持的电压越高,该层就越厚)。元件的耐压性能越高,漏极—源极之间的电阻也就越大。正因为如此,高耐压的功率MOSFET的通态电阻变大,无法使大量的电流顺利通过,因此实现大容量化非常困难。
针对这一点,IGBT中由于追加了p+层,所以从漏极方面来看,它与n基极层之间构成了pn二极管。因为这个二极管的作用,n基极得到电导率调制,从而使通态电阻减小到几乎可以忽略的程度。因此,IGBT与MOSFET相比,能更容易地实现大容量化。
正如图2所表示的理想的等效电路那样,IGBT是pnp双极型晶体管和功率MOSFET进行达林顿连接后形成的单片级联型Bi-MOS晶体管。此外,IGBT与双极型晶体管的芯片和功率MOSFET 的芯片共同组合成的混合级联型Bi-MOS晶体管的区别就在于功率MOSFET的通态电阻。在IGBT中功率MOSFET的通态电阻变得微小,再考虑到芯片间需要布线这一点,IGBT比混合级联型Bi-MOS晶体管优越。
(3)富士电机的IGBT技术
富士电机电子设备技术的IGBT技术从1988年开始产品化,至今一直在市场上供应。图3中表现了从第一代到第五代IGBT产品的开发过程以及运用技术。第一代至第三代的IGBT中运用了外延片,通过优化生命期控制和IGBT的细微化技术进行了特性的改善。然后第四代和第五代产品通过从外延片过渡为FZ(Floating Zone)晶片,实现了大幅度的特性改善。IGBT的设计方针与从前相比,发生了很大的转变。
首先,运用外延片的IGBT(第三~第四代的600V型为止的系列产品,被称为“击穿型”)的基本设计思想如下所述。IGBT在导通时为了实现低通态电压化,从集电极侧注入大量的载流子,使IGBT内部充满高浓度的载流子,再加上为维持高电压而专门设置的n缓冲层,形成很薄的n-层,从而实现低通态电压。为了实现快速交换,也同时采用以IGBT内充满的载流子快速消失为目的的生命期控制技术(通过这些也能实现低交换损耗(Eoff))。但是,一旦运用了生命期控制技术,即使处于通常的导通状态,由于该技术所产生的效果(载流子的输送效率下降),出现了通态电压增加的问题,而通过载流子的更进一步高注入化可以解决这个问题。总之,使用外延片技术的IGBT的基本设计理念可以用“高注入、低输送效率”简单扼要地概括出来。相对而言,使用FZ晶片的IGBT(第四代1200V以后的系列)采用了抑制来自集电极侧载流子的注入,并通过降低注入效率来提高输送效率的逆向基本设计。在前面所述的使用外延片的IGBT的设计理念“高注入、低输送效率”中,通过对生命期的控制,强制性地对注入的载流子进行抑制,这不仅使特性的改善受到了限制,而且通过对生命期的控制使通态电压特性的标准离差增大等问题,对于近年来要求日益提高的并列使用所需的大容量化等方面非常不利。为了攻破此难题而开发的技术就是运用FZ晶片的新IGBT(NPT:Non Punch Through(从第四代IGBT使用)/FS:Field Stop(从第五代IGBT使用)—IGBT)。该IGBT不采用生命期控制,其基本的设计思想是通过对集电极(p+层)的不纯物质浓度进行控制,从而抑制载流子的注入效率。然而,要实现优于采用外延片的IGBT的特性,对于1200V的耐高压系列IGBT也要求能够实现超薄型产品(使用了FZ晶片的NPT和FS-IGBT中n-层的厚度=芯片(晶片)的厚度,该厚度越薄越能产生低通态电压)。总之,将运用FZ晶片IGBT的开发称为对芯片厚度的挑战一点也不过分。
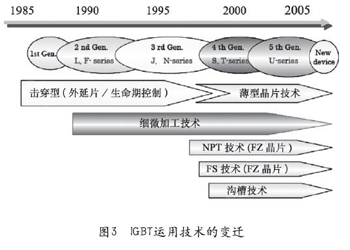
从第四代的1200V系列IGBT开始,实现了运用FZ晶片NPT构造的“S系列”的产品化。并且,进一步开发对厚薄度要求更高的600V系列技术,目前正在进行600V-U2系列(第五代)的产品化。此外,在1200V第五代“U系列”中,为了进行更优于S系列的性能改善,已经在将NPT构造改为FS构造。所谓FS构造,即不运用生命期控制技术,在遵循载流子的“低注入、高输送效率”的基本设计理念的同时,在FZ晶片上设置用以维持电压的n缓冲层,从而实现比NPT构造更薄的IGBT构造。通过这种改变,1200VU系列实现了优于S系列的低通态电压特性,并且完成了它的产品化。另外,此项技术还运用在1700V的高耐压系列中。
另外,IGBT的特性改善所不可缺的表面构造的细微化(IGBT是由多个IGBT板块形成的,通过细微化处理,板块数量越多越能实现低通态电压)。到第四代产品为止一直是 运用平面型构造(平面型制作IGBT的构造)来推进细微化,从而进行特性改善的。但是,从第五代产品1200、1700V系列开始,通过开发和运用在Si表面开槽并构成IGBT的沟槽IGBT技术,打破了细微化的技术屏障,实现了前所未有的特性改善。图4为1200V系列的特性改善的变迁情况。
(4)通过控制门极阻断过电流
在IGBT的产品化中最大的课题是,在有过电流流过时,通过控制门极来阻断过电流(进行保护),从而使“在不破坏元件的情况下安全地实施”变得可能。IGBT的实际等效电路如图5所示。这与图2的理想等效电路不同,是由晶闸管和功率MOSFET构成的。图5中,一旦晶闸管触发,由于晶闸管不会由于门极的阻断信号等而进行自动消弧,因此IGBT不可能关断,导致因过电流而破坏元件(这被称为“电性栓锁现象”)。
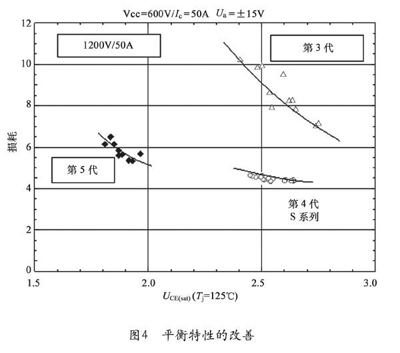
IGBT中,为了防止这种“电性栓锁现象”,充分运用了以下的技术:
(1)采用难以产生“电性栓锁现象”的构造(降低图5中基极-发射极间的电阻);

(2)通过优化n缓冲层的厚度和不纯物浓度来控制pnp晶体管的hFE;
(3)通过导入降低寿命的因素来控制pnp晶体管的hFE;
通过以上的技术,IGBT在能够维持充分保护过电流(短路)的最大耐受量的基础上,实现了高速交换、高耐压、大容量化,同时得到了产品化。
(5)限制过电流功能
在IGBT的实际使用上,由于装置的短路事故等原因,会出现IGBT上有过电流流过的情况。一旦这种过电流持续流过,元件自身的温度急剧上升,从而形成永久性的破坏。通常情况,从这种过电流开始流过到造成破坏的时间用“短路最大耐受量”来表示。另外,过电流越小,相对应的短路最大耐受量就变得越高(长)。IGBT方面的设计,已经设定成IGBT自身能限制几倍于额定电流的短路事故时的过电流,从而实现了在检测出过电流后能够加以充分保护的高短路最大耐受量。
(6)IGBT模块的构造
图6、7显示了具有代表性的IGBT模块的构造。图6中表示的端子台一体构造模块,是通过采用外壳与外部电极端子的一体成型构造,达到减少部件数量和减低内部配线电感的目的。另外,通过采用DCB(Direct Copper Bonding)基板,得到了低热阻和高抗折强度的高可靠性产品。图7表示的引线端子连接构造模块,并不是通过锡焊使主端子与DCB基板相连的,而是采用引线连接的构造。由此达到封装构造的很简易化、小型化、超薄化、轻量化和削减组装工作的目的。

表1中列出了IGBT模块的电路构造实例。

IGBT模块基本上以1in1、2in1、6in1及PIM(7in1)这4种形式存在的,分别构成表中所述的电路。
2 IGBT应用中的注意事项
(1)IGBT模块的选定
使用IGBT模块时,需要考虑适宜选择何种额定电压、额定电流的IGBT模块。
①额定电压
IGBT模块的额定电压与适用装置的输入电源有密切的关系。这种关系用表2表示,参考此表来选择相应的元件。

②额定电流
IGBT模块的集电极电流变大时,UGE(sat)上升,发生的稳态损耗就变大。另外,交换损耗也同时增大从而使元件的发热增加。由于需要将使IGBT、FWD的结温控制在Tj≤150℃(从安全角度而言通常控制在125℃以下)使用,因此选定IGBT模块的额定电流非常重要。一旦选错,将导致元件破坏或招致长期性的可靠性降低。另外,在高频交换用途中,随交换损耗的增大(交换的次数越多,综合的交换损耗也越大),发热也会增大。作为大体标准,一般在装置的最大电流值元件的额定电流的情况下使用。另外,表3中也列举了IGBT模块的应用实例。
(2)静电对策与门极保护
IGBT模块的UGE保证值一般最大为±20V。在IGBT的G-E间外加超过UGES保证值的电压时,IGBT的门极就有损坏的危险。所以不要在G-E间外加超出保证值的电压。特别注意IGBT的门极对静电等非常敏感,因此在使用时一般要遵守以下几点:
①使用模块时,先让人体和衣服上所带的静电通过高电阻(1MΩ左右)接地线放电后,再在接地的导电性垫板上进行操作。
②使用IGBT模块时,要拿封装主体,不要直接触碰端子(特别是控制端子)部分。
③对IGBT端子进行锡焊作业的时候,为了避免由烙铁、烙铁焊台的泄漏产生的静电外加到IGBT上,烙铁前端等要用十分低的电阻接地。
④IGBT模块是在用IC泡沫等导电性材料对控制端子采取防静电对策的状态下出库的。这种导电性材料在产品进行电路连接后才能去除。
另外,在门极-发射极间开放的状态下,集电极-发射极间施加电压时,IGBT有可能受损。这是由于集电极电势的变化,如图8所示引起电流i流过,门极电势上升,IGBT开通,集电极电流流过,从而使IGBT发热甚至有受损的可能性。
产品装入装置时,在门极电路故障或者门极电路不能正常工作的状态下(门极开放的状态),主电路外加电压时,也会由于以上理由使IGBT受损。为了防止这种损坏的发生,推荐在门极-发射极间连接10kΩ(RGE)左右的电阻。

(3)保护电路设计
IGBT模块可能由于过流、过电压这类异常情况而受损。因此,在IGBT模块的运用中,设计能够避免异常情况保护元件的保护电路显得尤为重要。这些保护电路需要在充分了解元件特性的基础上,配合元件的特性进行设计。保护电路如果不与元件特性相匹配,那么即使安装了保护电路,元件也可能受损(比如说,在施加了过电流保护时阻断时间很长或者缓冲电路中的电容器电容量很小,从而产生尖峰电压等。)
(4)驱动电路设计
驱动电路的设计决定着能否充分地发挥元件的性能。驱动电路促使元件开通的正偏压电路和稳定地保护元件处于关断状态、同时加快关断速度的反偏压电路组成,根据各种不同条件的设定,元件的特性也发生变化。另外,驱动电路的接线方法不同也会出现元件的误动作问题。因此,设计最适当的驱动电路非常重要。

(5)并联连接
当IGBT模块用于控制大容量变换装置的大电流时,有时将元件并联使用。元件并联使用时,重要的是在设计时要使并联连接的元件中通过等量电流。一旦电流失去平衡,有可能由于电流集中流过单个元件而损坏元件。由于并联连接时的电流平衡随元件的特性和排线方法不同而变化,比如说有必要配合元件的 ,将主电路的排线做均等化的管理和设计。
(6)实际安装的注意事项
在IGBT模块实际安装时,下述几点需要特别注意:
①安装到散热片上时,要先在模块的反面涂上散热绝缘混合剂,再用推荐的力距充分旋紧。另外,散热片上安装螺丝的位置之间的平坦度请控制在100mm±10μm,表面粗糙度请控制在10μm以下。错误的安装将破坏绝缘,甚至有可能引起重大事故。
②不要做让模块电极的端子承受过大应力的排线。最坏的情况可能会引起模块内部锡焊的电气配线断线等问题。
(7)其它实际使用中的注意事项
①仅使用FWD而不使用IGBT时(比如在斩波电路等应用时),不使用的IGBT的G-E间加-5V以上(推荐-15V、最大-20V)的反偏压。反偏压不足时,IGBT可能由于FWD反向恢复时的dv/dt引起误触发而损坏。
②在模块的端子部分测定驱动电压(UGE),并确认外加了既定的电压(如果在驱动电路端测定,则该驱动电压为不受驱动电路终端所使用的晶体管电压下降的影响的电压,IGBT上即使未外加既定电压,它的不良情况也可能不被察觉,因而可能导致元件损坏)。
③通过产品的端子部位测定开通、关断时的脉冲电压等。
④使用时,避开产生腐蚀性气体场所。
⑤在产品的绝对最大额定值(电压、电流、温度等)范围内使用。一旦超出绝对最大额定值,可能损坏产品。特别是外加超出UGES的电压时,可能发生雪崩击穿现象从而使元件损坏。因此,务必在UGE的绝对额定值的范围内使用。
⑥考虑到万一发生意想不到的事故而损坏元件,务必在商用电源和半导体电子设备之间安装适当容量的保险丝或自动断路器,防止次生性破坏。
⑦在充分了解产品的使用环境、充分考虑能否满足产品可靠性寿命的前提下使用。
⑧反偏压门极电压UGE不足时,可能引起误触发,为了避免误触发,设定足够的-UGE的数值(推荐-15V)。
⑨如果开通dv/dt偏高,则对IGBT可能发生误触发。为了避免误触发,在最适当的门极驱动条件(+UGE、-UGE、RG等)下使用。
3 保护电路设计方法
(1)短路(过电流保护)
一旦发生短路,IGBT的集电极电流增加到超过既定值,则C-E间的电压急剧增加。根据这种特性,可以将短路时的集电极电流控制在一定的数值以下,但是在IGBT上仍然有外加的高电压、大电流的大负荷,必须在尽量短的时间内解除这种负荷。同时,根据IGBT的短路耐受能力,从发生短路起到电流切断时为止的容许时间也受到限制。
①短路模式及发生原因分析
·器件短路,如图9所示。原因:晶体管或二极管损坏。

·串联支路短路,如图10所示。原因:控制电路、驱动电路的故障或由于杂波产生的误动作。
